随着汽车电子和电力通信模块的快速发展,12oz及以上的超厚铜箔线路板逐渐成为一种具有广阔市场前景的特种PCB板,受到越来越多厂商的关注和关注;随着广泛应用
印刷电路板 在电子领域,对设备的功能要求越来越高。印制电路板不仅会为电子元器件提供必要的电气连接和机械支撑,还会逐渐被赋予更多附加功能,能够集成电源、提供大电流和高可靠性的超厚铜箔印制板逐渐流行起来PCB行业开发的产品,前景广阔。
目前,业内研发人员已成功开发出一种 双面印刷电路板 通过连续加厚电镀沉铜+多重阻焊印刷辅助的分层方式,成品铜厚10oz。但超厚铜的生产报道较少 多层印制板 成品铜厚12oz及以上;本文主要针对12oz超厚铜多层印制板生产工艺的可行性研究。厚铜步进控制深刻蚀技术+积层叠层技术,有效实现12oz超厚铜多层印制板的加工生产。
制造过程
2.1 叠层设计
这是一个4层,外/内铜厚度12 oz,最小宽度/间距20/20mil,堆叠如下:

2.1 加工难点分析
❶ 超厚铜蚀刻技术(铜箔超厚,不易蚀刻):采购专用12OZ铜箔材料,采用正负可控深蚀刻技术,实现超厚铜线路的蚀刻。
❷ 超厚覆铜技术:采用真空压填单面电路控制深刻蚀技术,有效降低压合难度。同时辅助硅胶焊盘+环氧树脂焊盘压合,解决超厚铜箔层压板白点、层压等技术问题。
❸ 同层线路二次走线精度控制:层压后伸缩测量、线路伸缩补偿调整;同时,流水线制作采用LDI激光直接成像,保证了两种图形的重叠精度。
❹ 超厚铜钻孔技术:通过优化转速、进给速度、后退速度、钻头寿命等,确保良好的钻孔质量。
2.3 工艺流程(以4层板为例)

2.4 过程
由于采用超厚铜箔,目前业内还没有12oz厚的铜芯板。如果核心板直接加厚到12oz,电路蚀刻难度很大,蚀刻质量难以保证;同时,一次成型后的电路压制难度也大大增加。,面临着更大的技术瓶颈。
为解决上述问题,在本次超厚铜加工中,结构设计时直接采购特殊的12oz铜箔材料。电路采用步进控制深刻蚀技术,即铜箔先在反面刻蚀1/2厚度→加压形成厚铜芯板→正面刻蚀得到内层电路图案。由于采用了逐级蚀刻,大大降低了蚀刻的难度,同时也降低了压制的难度。
❶ 线档设计
电路的每一层都设计了两组文件。第一底片需要做镜像,保证正反控制深刻蚀时电路在同一个位置,不会出现错位。
❷ 电路图形逆向控制深蚀刻

❸ 次级电路图形对位精度控制
为保证两线重合,第一次压合后应测量涨缩值,调整线涨缩补偿;同时,
LDI激光成像的自动对准,有效提高了对准精度。优化后,对准精度可控制在25um以内。

❹ 超厚铜蚀刻品质控制
为提高超厚铜线路的蚀刻质量,采用碱性蚀刻和酸性蚀刻两种方法进行对比试验。经验证,酸蚀电路毛刺更小,线宽精度更高,可以满足超厚铜的蚀刻要求。效果如表1所示。

凭借步进控制深刻蚀的优势,虽然层压难度大大降低,但如果采用常规方法进行层压,仍面临诸多问题,容易产生层压等质量隐患白点和分层分层。为此,经过工艺对比试验,采用硅胶垫压合可以减少贴合白点,但板面分布不均,图案分布不均,影响外观和贴膜质量;如果再辅以环氧树脂焊盘,压合质量明显提高,可以满足超厚铜的压合要求。
❶ 超厚铜叠层法

❷ 超厚覆铜品质
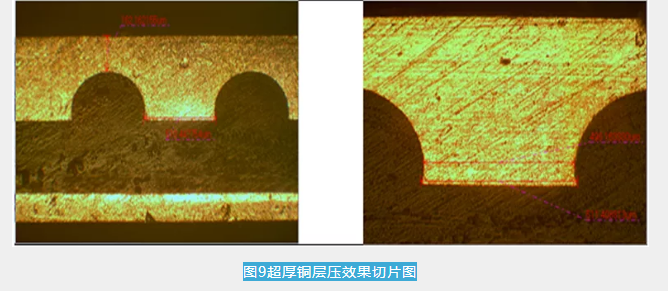
从层压片的情况来看,电路完全填充,无微缝气泡,整个深蚀部分深深扎入树脂中;同时,由于超厚铜侧蚀的问题,最上面的线宽远大于中间最窄的线宽20um左右,这个形状像一个“倒梯子”,将进一步提升握的紧逼,这是一个惊喜。
❷ 超厚铜堆积技术
采用上述步进可控深刻蚀技术+叠层工艺,逐层加层,实现超厚铜多层印制板的加工生产;同时,在制作外层时,铜厚仅约0.5mm左右。6oz,在常规阻焊工艺能力范围内,大大降低阻焊生产工艺难度,缩短阻焊生产周期。
超厚铜钻孔参数
全压后成品板厚3.0mm,整体铜厚达到160um,钻孔难度大。此次为了保证钻孔质量,特地就地调整了钻孔参数。优化后切片分析表明,钻孔无钉头、粗孔等缺陷,效果良好。





概括
通过超厚铜多层印制板的工艺研发,采用正负可控深刻蚀技术,采用硅胶焊盘+环氧树脂焊盘,提高层压时的贴合质量,有效解决了超厚铜线路刻蚀难 超厚层压板白点、阻焊层多次印刷等行业通病技术难题,成功实现了超厚铜多层印制板的加工生产;其性能经验证可靠,满足了客户对电流的特殊需求。
❶ 正负线步进控制深刻蚀技术:有效解决超厚铜线刻蚀问题;
❷ 正负对线精度控制技术:有效提高两个图形的重叠精度;
❸ 超厚铜积层压板技术:有效实现超厚铜多层印制板的加工生产。
结论
超厚铜印制板因其过流导通性能而广泛应用于大型设备电源控制模块。尤其是随着更全面功能的不断发展,超厚铜印制板必将面临更广阔的市场前景。本文仅供同行参考和借鉴。

 English 恩
English 恩